詳細介紹
真空壓力除泡機現在大部分使用的封裝材料都是高分子聚合物,即所謂的塑料封裝。上圖所示的塑料成型技術有許多種 ,包括轉移成型技術、噴射成型技術、預成型技術,其中轉移成型技術使用普遍。
2.2芯片切割
2.2.1、 為什么要減薄
半導體集成電路用硅片4時厚度為520um , 6時厚度為670μm。真空壓力除泡機這樣就對芯片的切分帶來困難。因此電路層制作完成后,需要對硅片背面進行減薄,使其達到所需要的厚度然后再進行劃片加工,形成一個個減薄的裸芯片。
2.2.2減薄工,藝
硅片背面減技術主要有:磨削、研磨、化學拋光干式拋光、電化學腐蝕、濕法腐蝕等離子增強化學腐蝕、常壓等離子腐蝕等減薄厚硅片粘在一個帶 有金屬環或塑料框架的薄膜(常稱為藍膜)上,送到劃片機進行劃片。現在劃片機都是自動的,機器上配備激光或金鋼石的劃片刀具。切割分部分劃片(不劃到底,留有殘留厚度)和*分割劃片。對于部分劃片,用頂針頂力使芯片*分離。劃片時,邊緣或多或少會存在微裂紋和凹槽這取決于刀具的刃度。這樣會嚴重影響芯片的碎裂強度。
 包裝印刷網
包裝印刷網


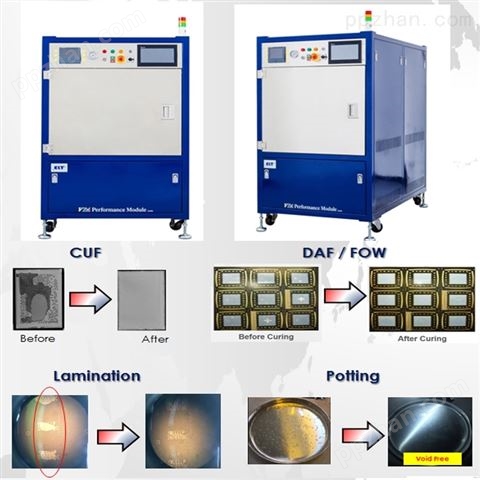




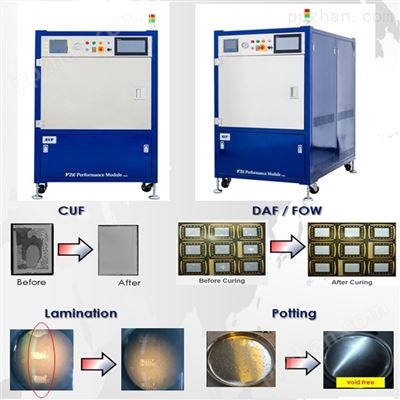


 包裝印刷網
包裝印刷網